Untersuchung der Eigenschaften von 2D-Schichtmaterialien mit Rasterkraftmikroskopie
Autoren: Andrea Cerreta, Alexander Klasen
Park Systems Europe GmbH, Mannheim, Germany
Nach der ersten experimentellen Charakterisierung von Graphen durch Geim und Novoselov im Jahr 2004 [1] hat in den letzten zwanzig Jahren das Interesse an zweidimensionalen (2D) Schichtmaterialien aufgrund ihres exotischen Verhaltens und möglicher nanotechnologischer Anwendungen zugenommen [2-5]. In der vorliegenden Arbeit werden Systeme beschrieben, die aus einer einzigen Atomschicht (einschließlich Graphit, Bornitrid, Übergangsmetall-Dichalcogenide usw.) oder durch das Stapeln solcher Schichten gebildet werden. Durch das Zusammenspiel chemischer und geometrischer Faktoren, wie der Art der gestapelten Schichten, der relativen Ausrichtung ihrer Einheitszellen außerhalb der Ebene, des Verdrehungswinkels zwischen aufeinanderfolgenden Schichten, des Vorhandenseins von Defekten oder Verformungen, lassen sich neuartige Materialeigenschaften erzielen. Da solche Systeme eine Modulation ihrer Eigenschaften auf der Nanoskala aufweisen, erfordert die experimentelle Charakterisierung von 2D-Schichtmaterialien hochauflösende Messtechniken.
In der vorliegenden Arbeit wird die Rasterkraftmikroskopie (AFM) als ein vielseitiges Werkzeug präsentiert, das die detaillierte Untersuchung korrelativer Eigenschaften der untersuchten Materialien ermöglicht.Die grundlegende Funktionsweise der AFM besteht in ihrer einfachsten Ausführung darin, dass eine scharfe Spitze, die auf einem Mikrohebel montiert ist, in Kontakt mit der Oberfläche der Probe gebracht wird. Sobald die Spitze die Oberfläche erreicht, führen starke, kurzreichweitige Abstoßungskräfte dazu, dass sich der Hebel verbiegt. Die vertikale oder torsionale Biegung des Hebels wird durch Reflexion eines Laser- oder SLD-Strahls auf einen positionsempfindlichen Photodetektor (PSPD) gemessen. Eine während des Scannens der Oberfläche etablierte Rückkopplungsschleife ermöglicht die Steuerung der Biegung und in Konsequenz die Steuerung der von der Sonde auf die Probe ausgeübten Kraft mittels Piezoaktoren. Die Positionierungsgenauigkeit dieser Aktoren liegt im Subnanometerbereich.
Beim Abtasten der Oberfläche mit konstanter Kraft erfährt die Sonde Schwankungen der Reibung zwischen Spitze und Probe. Diese werden durch den mechanischen oder materiellen Kontrast zwischen benachbarten Bereichen bestimmt. In der Folge kommt es zu einer Torsion des Cantilevers und einer horizontalen Verschiebung des reflektierten Strahls auf dem PSPD. Auf diese Weise wird eine Karte der lateralen Kraft erstellt, die als Lateral Force Microscopy (LFM) bekannt ist. LFM findet Anwendung bei der Analyse des Verdrehungswinkels von 2D-Doppelschichten sowie der Detektion von Domänengrenzen oder Dehnungen. Die durch die Gitterfehlanpassung verursachte feine Riffelung erzeugt ein Moiré-ähnliches Muster, das leicht identifizierbar ist (vgl. Abb. 1). Das resultierende Wabenmuster ist eine Folge des Versatzes der oberen hBN- und Graphen-Schichten, und seine Periodizität ist eine Funktion des relativen Verdrehungswinkels.
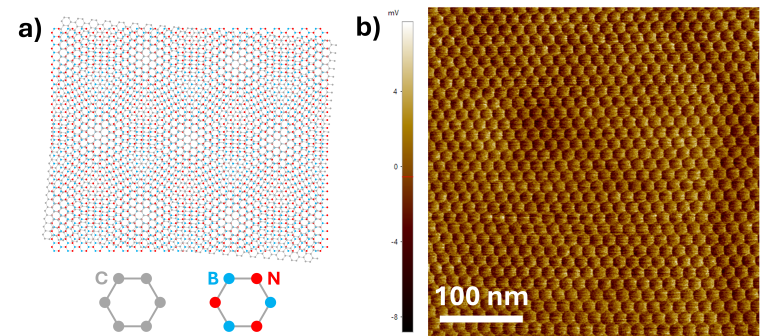
Ein direkterer Nachweis darüber, wie übereinanderliegende Monolagen die elektronischen Eigenschaften von Schichtstrukturen beeinflussen, kann mit dem leitenden AFM (C-AFM) erbracht werden.C-AFM basiert auf dem Kontaktmodus, bei dem eine zusätzliche Vorspannung an die Probe angelegt wird, sodass ein Strom durch eine leitende Spitze fließen kann, während sie die Probenoberfläche berührt. Der dabei gemessene Strom liegt typischerweise im Bereich von Femto- bis Mikroampere und wird über einen Stromverstärker erfasst. Aus dem so ermittelten Stromprofil werden Leitfähigkeitskarten erstellt, die der Topografie der Probe zugeordnet werden können.
Das folgende Beispiel veranschaulicht die Auswirkungen des Zusammenspiels der Ladungsdichte von zueinander verdrehtem zweischichtigem Graphen (TBG), das auf einem hBN-Kristall abgeschieden wurde (mit freundlicher Genehmigung: Prof. Machida, Institute of Industrial Science, University of Tokyo, Japan). Die an die untere Graphenschicht angelegte Vorspannung erzeugt einen Strom, der bis zum Kontaktpunkt zwischen der AFM-Spitze und der oberen Graphenschicht fließt. Es wird erwartet, dass Moiré-Muster zu beobachten sind, die an den relativen Winkel zwischen den beiden Graphenschichten im LFM erinnern. Darüber hinaus wurde ein zusätzlicher Moiré-Kontrast beobachtet, der in seiner Stärke vom Vorhandensein des darunter liegenden hBN und dessen eigener Ladungsdichte abhängt. Dieser zusätzliche Moiré-Kontrast moduliert den Gesamtstromtransport auf einer sehr feinen Skala, wie in [6] beschrieben.
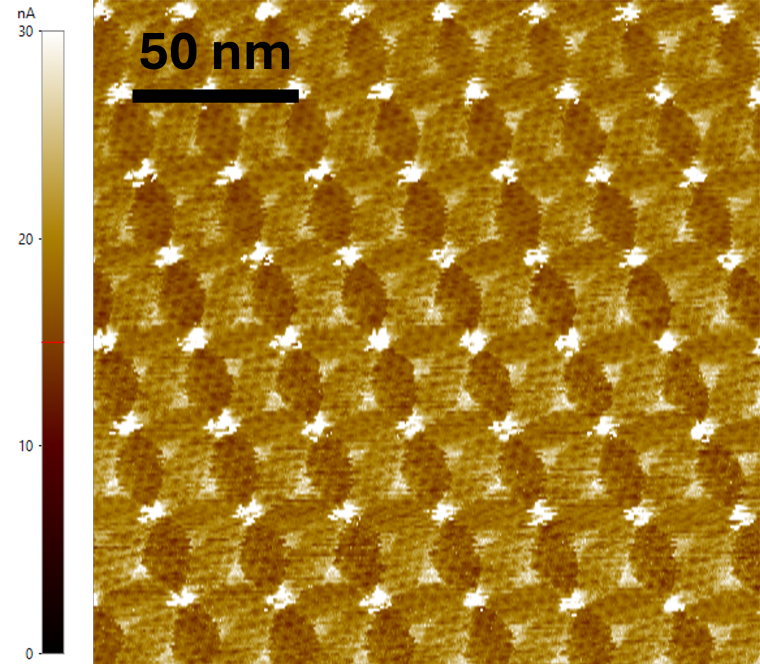
Komplexere AFM-Implementierungen, die oft die Verwendung zusätzlicher Hardware erfordern, liefern Informationen über die elektrischen Eigenschaften der Proben. Zu diesen Eigenschaften zählen beispielsweise die Austrittsarbeit oder die ferroelektrische Polarisierbarkeit. Die Kelvin Probe Force Microscopy (KPFM) beispielsweise ermöglicht die Messung der Kontaktpotentialdifferenz zwischen der leitenden AFM-Sonde und der Probe. Bei zweidimensionalen Strukturen, wie den hBN-Doppelschichten über Graphen in Abbildung 3, führen lokale atomare Rekonstruktion und Schichtdehnung zu unterschiedlichen Domänen aufgrund von Polarisierung außerhalb der Ebene, die sich aus der unterschiedlichen Stapelung ergibt [4].

Dieser kurze Überblick demonstriert, dass AFM-Modi ergänzende Informationen liefern, um einen tieferen Einblick in die Natur der beobachteten Verhaltensweisen auf 2D-Materialien zu erlangen. Aus Sicht der Anwender:innen ist es daher wünschenswert, dass kommerzielle AFMs die Möglichkeit bieten, verschiedene Modi auf denselben Bereich der zu beobachtenden Probe anzuwenden. Die FX-Serie von Park Systems erfüllt diese Anforderung und ermöglicht den Wechsel von Standard- zu erweiterten Modi ohne Hardware-Modifikationen. Darüber hinaus sind fortschrittliche Implementierungen wie Sideband™ und heterodyne KPFM in der Standardkonfiguration der FX-Geräte verfügbar.
Zur Veranschaulichung der korrelativen Bildgebung mit dem FX200 von Park Systems sei auf Abbildung 4 verwiesen, welche den gleichen Bereich einer leitfähigen Siliziumkarbidprobe (mit freundlicher Genehmigung von Dr. Rejhon vom Institut für Physik der Karlsuniversität Prag, Tschechische Republik) zeigt, welcher mit verschiedenen Techniken untersucht wurde. SiC kann als Ausgangsmaterial verwendet werden, um durch thermische Behandlung bei hoher Temperatur große Graphitflocken zu bilden. Dadurch verlassen die oberflächennahen Si-Atome nach und nach den Kristall, was zu ein- oder mehrlagigem Graphen auf einer Graphenartigen Pufferschicht auf dem SiC-Kristall führt. Darüber hinaus wurde über die Bildung streifenförmiger Domänen berichtet, die im C-AFM beobachtet werden können, sowie über den Nachweis eines Versatzes des Oberflächenpotenzials zwischen Bereichen mit unterschiedlicher Leitfähigkeit und Domänentopologie [7].
In Abbildung 4 b) wird die Korrelation zwischen der Variation der Austrittsarbeit und dem Vorhandensein unvollständiger Terrassen auf den Hauptstufen des SiC deutlich. Zudem wird beobachtet, wie sich der KPFM-Kontrast in Bereichen nahe kristalliner Defekte verändert. Ein anschließendes Umschalten auf den C-AFM-Modus ermöglicht die nahtlose Abbildung der Leitfähigkeit in derselben Region. Daten, die mit höherer Auflösung in einem Bereich an der Grenze zwischen den Regionen mit unterschiedlichem Potenzial erfasst wurden, zeigen eine Verschiebung des durchschnittlichen Stromflusses bei konstanter angelegter Probenvorspannung (5 mV). In beiden Regionen sind feine streifen- und quasi dreieckförmige Domänen zu erkennen, deren Ursprung mit einer strukturellen Umlagerung mehrerer Graphenschichten erklärt werden kann.
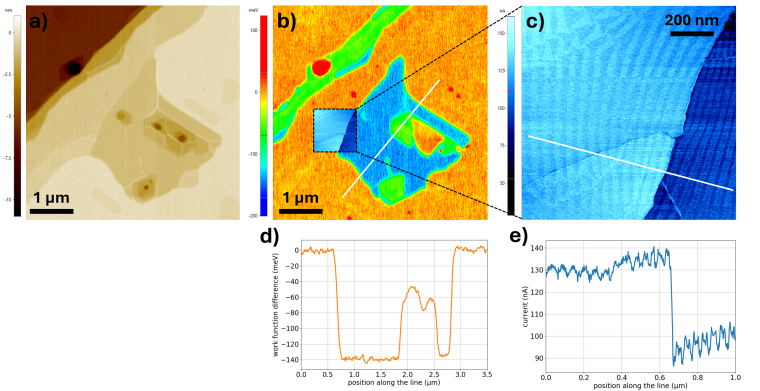
Zusammenfassend lässt sich sagen, dass das AFM eine Plattform zur vielseitigen Charakterisierung von 2D-Proben mit allen Informationen bietet, die die verschiedenen AFM-Modi liefern. Forscher können sich diese Vielseitigkeit zunutze machen, wenn sie die grundlegenden Eigenschaften und Anwendungen dieser Strukturen untersuchen. Damit wird das AFM zu einer unverzichtbaren Technik zur weiteren Erforschung der komplexen und faszinierenden Welt der 2D-Materialien.
[1] K.S. Novoselov et al., Science 306, 666-669 (2004)
[2] B. Radisavljevic et al., Nat. Nanotechnol. 6, 147-150 (2011)
[3] X. Wang et al., Nat. Nanotechnol. 17, 367–371 (2022)
[4] C. R. Woods et al., Nat. Commun. 12, 347 (2021)
[5] R. Ribeiro-Palau et al., Science 361, 690-693 (2018)
[6] L. Chen et al., Carbon 213, 118271 (2023)
[7] M. Rejhon et al., PNAS 121, e2408496121 (2024)
Das Park FX200 ist ideal für Forschung und Industrie zur automatisierten Messung von bis zu 200mm großen Proben und bietet bedeutende Fortschritte in der AFM-Technologie.














